銅箔業者,經常接到客戶報怨“他們加工制造的CCL或PCB發生脫層”,其實很多時候,脫層是因構成基板的樹脂發生不良所致,使用動態機械分析儀(Dynamic Mechanical Analyzer,DMA)可以幫助確認這個問題。
銅箔在成膜后,尚需歷經表面粗糙化及活性化,目的是為增強與基材間之黏結力。經過廠內品檢合格的銅箔送交下游銅箔基板(CCL)廠,放置在堆棧好的樹脂預浸板最外層,依需要熱壓成單面或雙面基板,即是一般所謂的銅箔基板。接著,將此CCL送交下制程依續完成線路制作步驟,稱為線路基板。然后,若要制作多層板時,尚需將線路基板與預浸板堆棧后再經過熱壓合的步驟,此時CCL已是二次受熱了。之后,再要經外層線路涂布防焊漆、鉆孔、電鍍等熱及化學處理過程,最后的成品稱為印刷電路板(PCB)。通常,各種電子零件會以焊錫固定在PCB 上,此焊接過程又增加一次受熱過程。
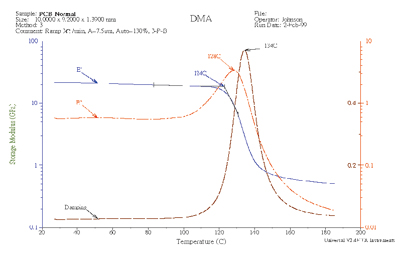
圖1. PCB的DMA標準圖譜。
在先后若干次的受熱過程中,由于銅箔與基板間的接著不佳,或者基板劣解變質,或者基板釋出水或其它小分子等不良作用,均可能導致銅箔與基板間引起脫層現(Delamination),造成CCL 或PCB 的不堪使用。
身為銅箔業者,最常接到的客戶報怨,就是他們加工制造的CCL或PCB發生脫層而要求索賠。其實很多時候,脫層是因構成基板的樹脂發生不良所致,銅箔只是受到牽連而已。但是,如何證明是基板樹脂不良呢?善用動態機械分析儀(Dynamic Mechanical Analyzer,DMA)可以有效幫助解答這個問題。
首先,完成正常CCL或PCB的DMA圖譜以為標準,并建檔,當然,試片要先將防焊涂料與表面銅箔處理掉。其次,分析發生脫層的CCL或PCB的DMA圖,以發現其環氧樹脂的反應質量。
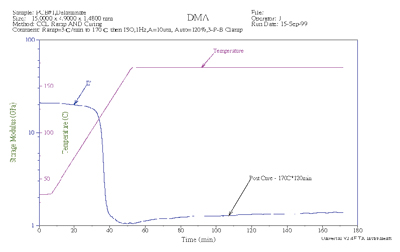
圖2. 去防焊、去銅箔的PCB#1板升溫至170℃,觀察2小時后的DMA圖。
PCB的DMA標準譜圖如圖1所示,在DMA圖中通常會顯示三個黏彈量:彈性模量(Storage Modulus,E’),可以視為材料的軟硬度;黏性模量(Loss Modulus,E”),可以視為材料的運動磨擦能量損失;阻尼(Damping,Tan Delta),即E”/E’,每儲存一個單位能量的同時所損失的能量。從圖1中可以看出,FR4 級PCB的軟化溫度為124℃,E”的峰值為128℃,Damping的峰值為134℃,傳統以來,一般習慣取阻尼峰值為Tg,是前述三個值中最高的。圖1中在整個玻璃轉移范圍內(100~180℃)阻尼的形狀恰如一鐘狀常態分布圖,表示交聯的三度空間環氧樹脂網目(Network)的大小分布也是常態分布,較低溫度的阻尼強度代表寬大網目的比率,而較高的溫度的阻尼強度代表細密網目的比率,常態分布表示反應均勻,無過度反應(Over Curing)或反應不足(Under Curing)。
案例1
PCB#1,在焊錫后發現電路孔四周有輕微脫層現象,但將PCB施以170℃與2小時的后反應之后,脫層有改善,故先將去防焊、去銅箔的PCB板升溫至170℃觀察2小時,結果見圖2。本圖說明在Tg后的橡膠區持溫使反應得以持續,此由E’值穩定的增加而加以證實。也就是說,本試樣的問題在于反應不足。
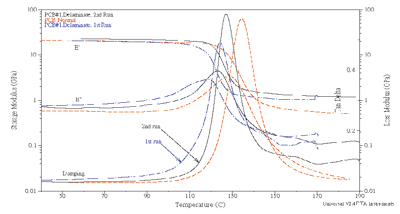
圖3. 正常PCB、發生脫層的PCB#1的第一次加熱圖、經170℃后反應2小時的第二次加熱圖比較。
將圖1正常PCB、會發生脫層的PCB#1的第一次加熱圖、經170℃后反應2小時的第二次加熱圖重迭比較,顯然發現經后反應的PCB其Tg提高了,阻尼圖也接近正常,唯Tg仍較正常低,且高溫部份有肩形(Shoulder),表示二次加熱的PCB反應均勻度畢竟比較差,見圖3。
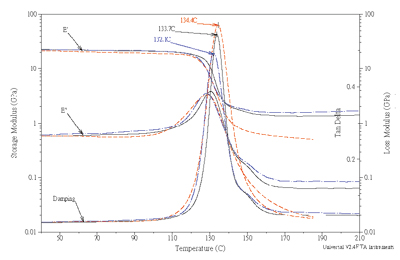
圖4. CCL#2發生脫層的局部、稍遠于脫層處的局部、標準品的DMA比較。
案例2
CCL#2,發現表面銅箔有局部脫層現象,由此做成的PCB #4,在焊錫后仍發現電路孔四周有脫層現象。首先將CCL#2表面銅箔除去后,各取在發生脫層的局部與稍遠于脫層處之局部各完成DMA測試,并與標準比較如上,結果見圖4,由此可知遠離脫層處的特性圖較接近標準圖,而脫層處的阻尼顯然強度較矮Tg較低,故可判斷本件樣品的Network結構并不均勻,其原因可能是如下幾點:1,熱壓合溫度控制并不均勻;2,耐熱性差,由于Over Curing 造成劣化,使Tg降低,且不均勻。經進一步分析,將證明由CCL#2所制作的成品PCB#4,其所發生的導電孔周圍脫層的成因是原因2所致。圖5中,除去防焊油墨與銅箔的樣品,其阻尼峰Tg值由134℃降為124℃,并且阻尼峰不是鐘形對稱,Network 結構有所破壞,表示在由CCL→PCB 的過程中環氧樹脂持續劣化。另外,在本項試驗中,也比較了未將防焊油墨去除的DMA圖譜,發現其阻尼峰Tg值由124℃降為114℃,表示防焊油墨會影響測試結果。
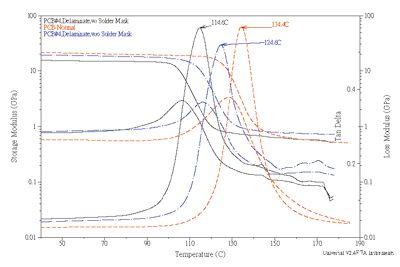
圖5. PCB#4與標準品的DMA譜圖比較。
案例3
PCB#3,在焊錫后發現電路孔四周有輕微脫層現象,故先將防焊油墨與銅箔磨去以后,將試樣在DMA中先后試驗兩次(1st Run與2nd Run),并與標準圖譜比較,如圖6。可以看出第一次升溫的阻尼峰僅120℃,而第二次升溫的阻尼峰達127℃,表示PCB#3的反應并未完全,證實了本試樣的問題仍在于環氧樹脂的反應不足,而不是銅箔質量有問題。
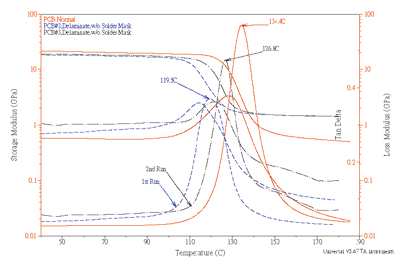
圖6. PCB#3兩次DMA測試結果與標準譜圖的比較。